ロックイン発熱解析装置「ELITE」
概要
発熱解析とは、通電によって異常箇所を発熱させ、その発熱部位を高感度赤外線カメラで観察することで、実装基板、電子部品内部、半導体チップ内部の異常箇所を特定する手法です。
非常に微小な発熱状態を検知できることから、通常のプリント基板だけでなく、半導体の不具合解析にもその威力を発揮します。
特にショート箇所の調査においては、複雑な構造であっても短時間で場所の特定が出来るため、不具合解析の時間を劇的に短縮することができます。

分析原理と特徴
分析原理
観察装置と電源を同期させて通電させることで、異常箇所だけの発熱を捉え続けます。
その為、「熱拡散によって発熱中心が分からなくなる」ことを防ぎ、微小なリーク・変化でも検出が可能です。
特長
1)非破壊で不良解析ができ、サンプル加工などによる故障箇所喪失リスクがありません。
2)半導体単体から、モジュール、実装基板など幅広い製品の観察が可能です。
3)従来のマニュアル検査に比較して不良特定率が向上します。
4)赤外線強度データと位相データの解析により、不良部位のXYZ位置特定が可能です。
発熱解析事例
1 基板不良箇所の特定
最大約20㎝角の広角カメラにより、大きな基板等のサンプルでも解析可能です。
広角カメラで不良箇所を特定した後に、高倍率カメラによる解析で、さらに詳しい不良箇所を特定します。
ELITEにて発熱箇所を確認し、基板内の異常箇所を特定します。
ELITEの特徴である位相(ロックイン信号入力から発熱検出までの時間差)を測定することで、不良箇所の深さ方向の推定も可能です。
また基板解析の経験は豊富にございますので、その経験を基に不良箇所の特定や、断面解析による原因特定にも対応します。
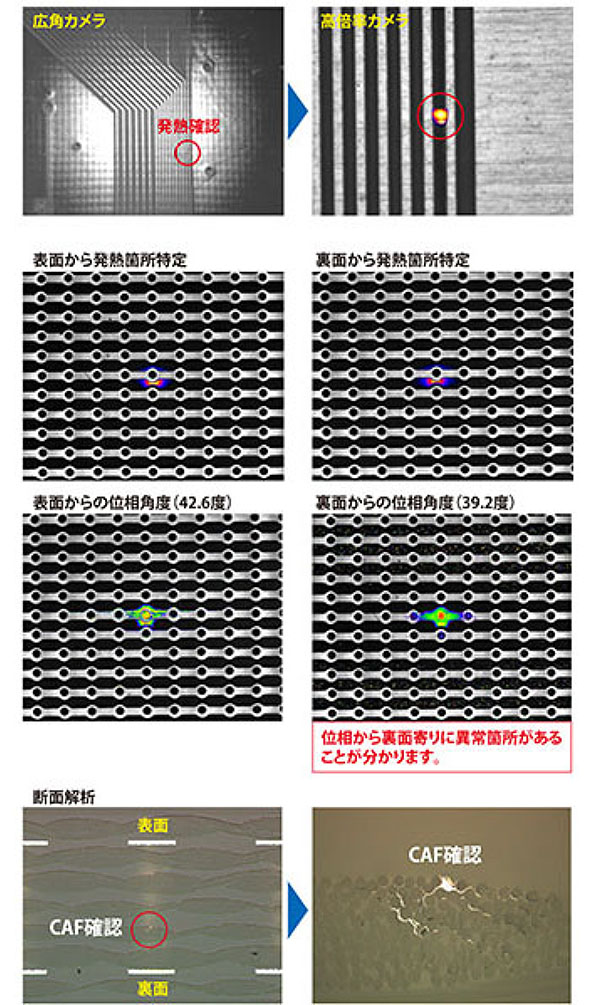
2 IC不良箇所の特定
パッケージ状態(非破壊)で不良箇所特定、樹脂開封を行いチップ配線の不良箇所特定まで対応します。
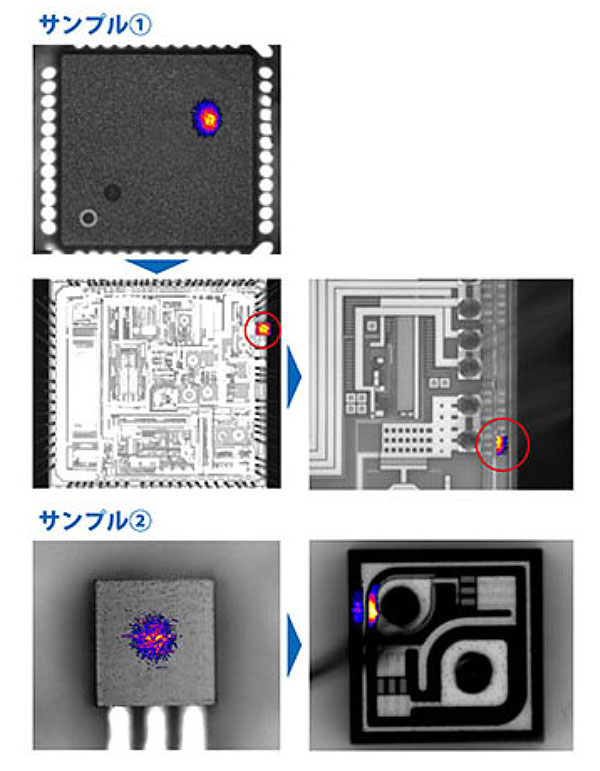
設備機器紹介
-
ロックイン発熱解析