故障解析事例(静電気破壊の再現実験)
サンプルとして最新のRC-IGBT(Reverse-Conducting IGBT)を用いました。
ゲート構造はトレンチ型で、コレクタ層にn+層を加えることで逆方向ダイオードを内蔵した設計となっています。
IGBTの故障モードと半導体チップの故障原因
半導体チップの故障原因は、大きく分けて二つあります。
1)IGBT製造上の問題
・ゲート絶縁膜破壊
・接合リーク
2)実装、使用上の問題
・静電気破壊
・アバランシェ破壊など
故障箇所と故障モードについては、下の図をご参照ください。
故障解析 手順
故障箇所が変化しないように、ストレスの少ない手法から選んで故障箇所を絞り込んでいきます。初動調査(外観観察、電気的特性測定)
↓
非破壊検査(X線観察、超音波顕微鏡など)
↓
故障箇所特定(ロックイン発熱解析、IR-OBIRCHなど)
↓
物理解析(断面研磨、SEMなど)
↓
詳細解析(FIB、FE-SEM/EDS、STEMなど)
静電気破壊の再現実験
静電気試験の規格には大きく分けてデバイスレベルのものとシステムレベルのものがあり、静電気の発生源の違いから、さらに複数の規格に分かれます。
今回はシステムレベルの規格として広く用いられるIEC61000-4-2に倣って、人体からの放電を模擬したESD破壊の再現実験を行いました。
非破壊解析(X線透視と超音波顕微鏡)
サンプル外観に異常のないことを確認後、静電気破壊(ESD)品を非破壊にて解析しました。
破壊箇所を特定することができない程、破壊規模が小さいことが分かります。
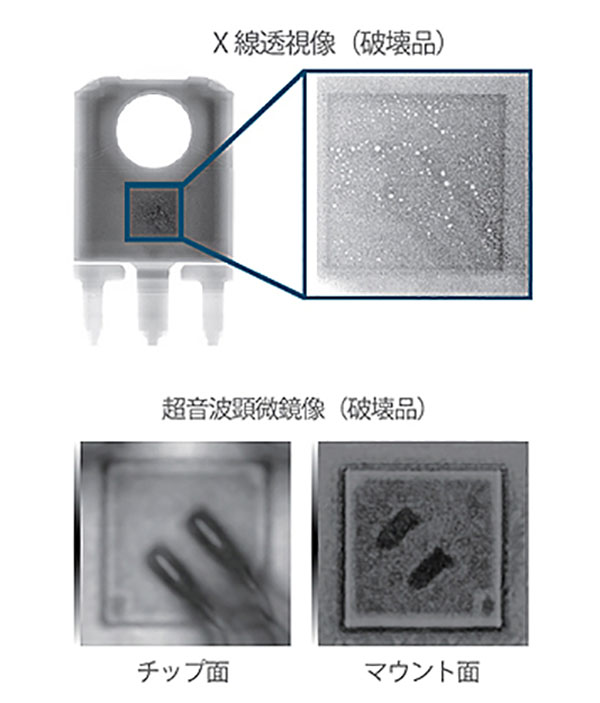
半導体チップの破壊箇所特定
(ロックイン発熱解析/Lock-In Thermography)
モールド樹脂をレーザと薬液により開封し半導体チップを露出。
チップ表面の観察後に、ロックイン発熱解析を行い、微小な故障箇所を特定できました。
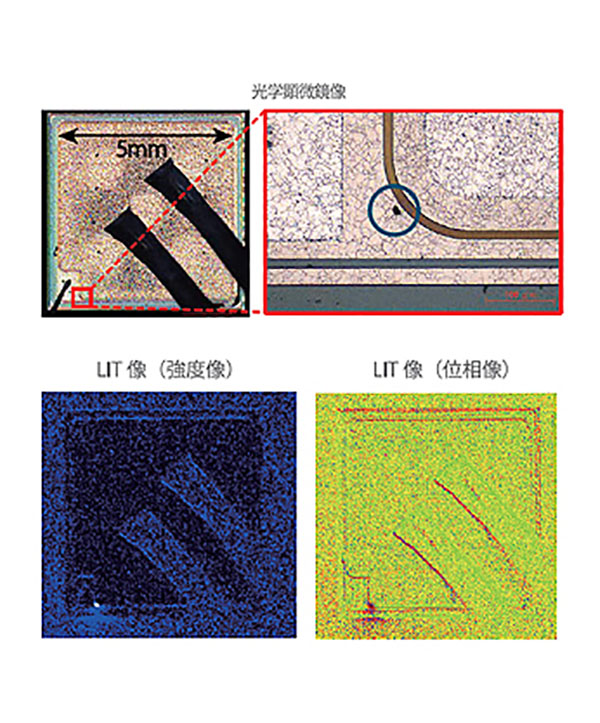
破壊箇所の詳細解析(FE-SEM、プラズマFIB/EDS)
最新のプラズマFIB装置を用いて断面を観察した結果、表面のクレーターから、トレンチゲート及びその直下のコレクタ領域まで広く破壊されている様子が確認されました。