即日対応可能!半導体パッケージ開封サービス
概要
当社では、薬液条件の改善とともに、レーザ開封設備も併用することで薬品の浸漬時間を短縮し、ワイヤへのダメージ低減ができる開封を実現しています。
また、レーザ開封設備に関しては薬液ダメージ低減だけでなく、高い加工位置精度を有しておりますので、微小ICの高精度加工も可能となっています。
パッケージ開封なら即日対応も可能です。
パッケージ開封事例
Agワイヤ
AgワイヤはAu・Cuワイヤよりも開封時の薬品の影響が大きく、特殊な開封手法が必要となりますが、Au・Cuワイヤで⻑年蓄積した技術に基づき、飽和法を利用したAgワイヤの開封を可能にしました。
パワーデバイスなどの樹脂開封
高硬度樹脂や金属基板を用いるパワーデバイスは内部構造が一般ICより複雑ですが、断面研磨技術と多様な試料作製により高難度な樹脂開封にも対応します。
開封後の不良解析
非破壊検査後、半導体の不具合が疑われる場合には、半導体パッケージを開封し半導体チップ表面の直接観察により故障原因を特定します。
また、発熱解析(ELITE)やRIE(層剝離)を組み合わせることで、より詳細な故障原因調査も可能となります。
ワイヤボンディングの各種接合評価
強度試験は樹脂開封とセットでご依頼可能
半導体製造におけるワイヤボンディングの接合強度は、部品の信頼性を評価するための重要な目安となります。当社ではMIL-STD-883に基づく試験および評価を実施しており、強度数値の測定だけでなく破断モードの判定が可能です。
ボンディングの接合評価は⾦属間化合物の⾯積も重要
接合状態を正しく評価するには、接合面での金属間化合物の生成状態を観察する必要があります。当社ではボンディング箇所の裏面からシリコンをエッチングすることで、金属間化合物の面積を算出し、数値による定量的な評価が可能です。
電子部品の真贋判定(流通在庫部品の検査)
電子部品の真贋判定は、模倣品による製品故障、発煙・発火事故、製造ラインの停止、ブランド価値低下を防ぐために不可欠となります。当社では各種検査を実施し、製品に偽造品の疑いがないか鑑定を行います。同時に品質検査を行い、部品に問題ないか確認。総合的な結果をご報告いたします。
■ 真贋判定の流れ
①非破壊検査
(外観検査、リマーク検査 ▶ 電気特性 ▶ X線検査)
②破壊検査
(内部観察 ▶ 開封調査(チップ、ボンディング状態、欠陥有無)・断面調査(厚み、層構造))
③まとめ
合否判定、懸念事項の報告 など
■ 対象部品
LSI、パワーデバイス、LED、LCR部品など
■ 使用装置
・外観、リマーク検査:マイクロスコープ、光学顕微鏡など
・電気特性:カーブトレーサ、LCRメータなど
・X線検査:X線透過、X線CT装置など
・内部観察:樹脂開封、研磨装置、FIBなど
■ 解析事例(IC)
-
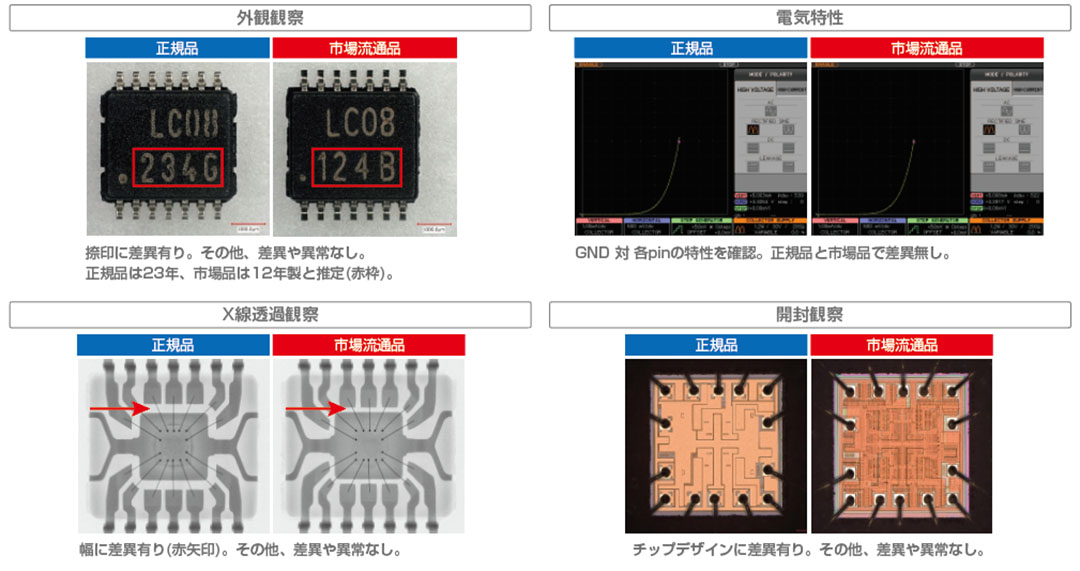
結果:正規品と市場品に僅かな差が見られたが、製造年月による仕様変更と推定される。その他、異常はないことから問題なしと判断。
設備機器紹介
-
層剥離装置RIE-10NR(samco製)
-
ロックイン発熱解析