不良品や模造品の事前判定に役立つ、良品解析・真贋判定
良品解析とは
FMEA(故障モード影響解析)やFTA(故障の木解析)などの製品故障の未然防止手法の一つで、非破壊検査・破壊検査と各種解析技術で評価し、潜在的に存在する問題点を検査する方法のことをいいます。
故障解析との違いは、故障解析が故障要因のみを調査するのに対し、良品解析では潜在的な問題点を探し出す必要があるため幅広く調査します。
必要な設備や技術は同じです。
良品解析手順
ICの場合の代表的な検査項目を紹介します。
①外観検査
各種光学機器でパッケージや端子を観察します。
・パッケージ外観(汚れ、異物付着、キズ、クラック、樹脂バリなど)
・端子(変形、キズ、めっきムラなど)
・捺印表示
②X線透視検査
X線により電子機器内部の状態を観察します。
非破壊の解析手法として広く用いられています。
半導体デバイスでは、パッケージ内部の異物や、ワイヤボンディングの変形などを観察します。また、電子部品では、はんだ実装のボイドや、クラックの検査に用いられます。
■分析用途
1.異物混入の内部観察
2.スルーホールやパターン断線等のオープン不良解析
3.ショート不良解析
4.はんだボイドの観察
5.ワイヤーボンディングの観察
6.構造解析

■各種観察例
③電気的静特性測定
IC静特性検査では、カーブトレーサを使用します。
カーブトレーサはダイオードやトランジスタ、光電子部品などの各種半導体素子の電流-電圧(I-V)特性を測定するための装置です。
良品解析では、データシートを基に仕様通りの特性を有しているかを検査することを目的とし、故障解析では、良品との波形比較を行い、異常箇所を特定することを目的としています。
■分析用途
・ダイオードの順方向電圧、逆方向リーク電流、逆方向ブレークダウン電圧
(写真1参照)。
・ダイオードやトランジスタ、MOSFETの特性評価(写真2参照)。
・ダイオードやトランジスタ、及びIC/LSIの故障解析。
・トランジスタのVTHやhFEの測定。
④超音波顕微鏡観察
高周波帯域の超音波を利用し、対象サンプルの内部及び外部の観察を行います。
超音波は音響インピーダンスの異なる物質の境界面で透過・反射する性質を持ち、検出された波形を解析することで部品内部の状態を非破壊にて調査可能です。
特に「空気に対する反射感度が高い」ことから、ICなどの半導体デバイスにおけるパッケージ剥離検査や物質同士の接合状態の検査などに使用します。
■解析事例
1)IC 内部 剥離検査

X線透視観察:ワイヤ断線は確認出来るが、界面剥離はわからない。

超音波顕微鏡観察:剥離発生(波形異常)を検出し発生箇所を視覚的に判断出来る。
2)IC 内部 剥離検査と断面観察
3)アンダフィルボイド観察、チップ接合部、表面観察
-
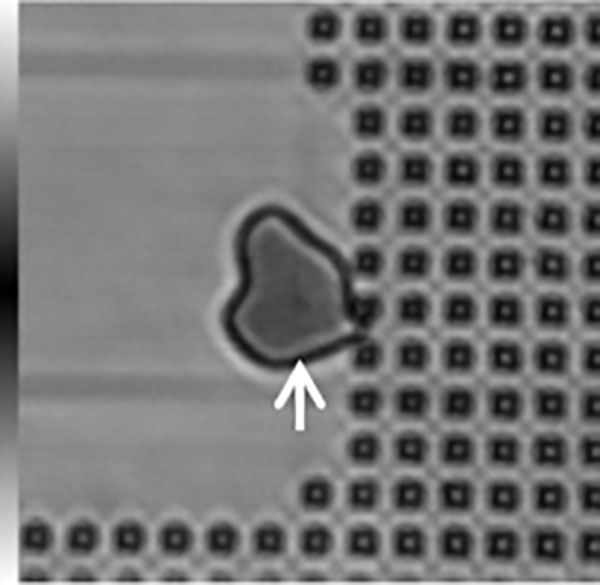
アンダフィル内のボイド観察(矢印)
-

チップ接合部異常観察(矢印)
-

チップ表面異常観察(矢印)
⑤断面観察
破壊検査で、各部の断面サンプルを作製し、光学、あるいは、SEMを用いて下記に示す各部の項目を観察します。
・端子異常(キズ、めっきムラ、空隙など)、
・パッケージ異常ダイボンディングの状態(ダイペースト形状など)
・ダイボンディングの状態(ダイペースト形状など)
・ワイヤボンディングの状態(金属間化合物の生成状態など)
⑥IC開封
半導体デバイスのパッケージ樹脂を薬品などによって溶解し、内部の半導体チップを露出させます。
弊社では、薬液条件の改善とともに、レーザ開封設備も併用することで薬品の浸漬時間を短縮し、ワイヤへのダメージ低減ができる開封を実現しています。
また、レーザ開封設備に関しては薬液ダメージ低減だけでなく、高い加工位置精度を有しておりますので、微小ICの高精度加工も可能となっています。
ワイヤダメージが少ない、あるいは、ほぼ無い状態で開封することができますので、故障解析における故障個所の観察や良品解析におけるワイヤの接合試験の評価を行うことができます。
⑦ワイヤボンディング評価
良品解析では、ICの開封後、チップ内の配線状態を観察すると共に、ボンディングワイヤの接合状況を評価します。
MIL-STD-883G method 2011に準拠して実施しております。
・ワイヤプル試験→デバイス内部1st、2nd間及びワイヤの強度を数値、破断モードから評価します。
最大荷重:10kgf
治具種:50gf、5kgf、10kgf
引張速度:ご相談下さい(弊社標準:10mm/sec)
・シェア試験→ダイ・パッドなどのボンディング部の強度(溶着度)評価します。
最大荷重:10kgf
治具:500gf、10kgf
治具幅:80、150、250μm
速度:ご相談下さい(弊社標準:18mm/sec)
・ピール試験→ボンディングワイヤをつかむ形で引張り、2ndボンディング部の破断モードから評価します。
装置名:表面実装部品はんだ接合強度試験機(RHESCA STR-1000)
特 徴:プル・シェア・ピールなど多様な試験用途に対応可能です。
X、Y、Z、θ(台座の角度調整)を同時に変更できます。